IC package thermal warpage
Thermal-structural analysis of FCBGA packages using cloud DDM
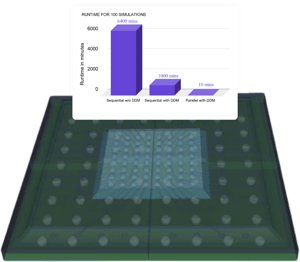
Solid mechanics • Heat solid
The challenge
Modern IC packages (like Flip-Chip BGAs) contain thousands of micro-features—solder balls, underfill layers, and routing tracks.
Simulating thermal warpage requires high-resolution 3D meshes that exceed the memory limits of desktop workstations. Engineers are often forced to use 2D approximations or symmetry assumptions, which compromises reliability predictions.
Approach with Quanscient Allsolve
The study utilized Domain Decomposition Method (DDM) on the cloud to solve the full high-fidelity 3D model without simplification.
The simulation included a Mesh Convergence Study to guarantee accuracy and a 2-Variable Parametric Sweep (Temperature vs. CTE) of 100 simultaneous runs to map the design space for structural integrity.
Key results
- Scalability: By scaling from 1 node to 60 cloud nodes using DDM, the simulation runtime was reduced by over 85%.
- High Throughput: Successfully executed 100 design variations in parallel, replacing weeks of sequential analysis with a single batch run.
- Full Fidelity: Captured the z-displacement (warpage) of individual solder balls and substrate layers without artificial geometric simplification.
